
作为TGV激光钻孔设备的核心供应商,深圳市圭华智能科技有限公司深耕赛道多年,早在2019年便前瞻性布局TGV高端装备领域,通过持续的技术研发,多项关键指标实现行业突破,TGV设备交付国内半导体封装与显示行业头部企业,并通过产品验证。

圭华智能主要通过激光+蚀刻的方式实现TGV玻璃通孔,红外超快激光器对玻璃基板进行预处理,化学湿法工序形成通孔,最终在玻璃上实现微孔加工。TGV 整体解决方案主要制成设备包含了 TGV 激光钻孔设备、TGV 化学湿法蚀刻设备、TGV AOI检测设备。
圭华智能TGV整体方案解决了通孔成型的技术难点,满足高速、高精度、窄节距、侧壁光滑、垂直度好及低成本一系列优势:
1.孔径尺寸:2-200um
2.行业内最高深径比: 200:1
3.可加工玻璃厚度:0.2-1.5mm
4.可通孔、盲孔、异型孔、集群阵列孔等;
5.平台加工尺寸:300*300mm , 510*515mm;
最大可支持730*920mm的玻璃基板,可适配4寸-12寸晶圆
6.可加工产品材质:BF33、AF32、D263T、EXG、石英玻璃等
7.最大速度可达到:10000孔/秒
区别于市面上其他设备的高温纯碱蚀刻工艺,圭华掌握独家蚀刻液配方,兼容低温至高温,药水使用周期长,无需频繁更换。工艺的可控性与稳定性,是保障量产良率的核心关键,具体优势如下:
1.恒定速率蚀刻
2.蚀刻液浓度不敏感,温控工艺窗口宽
3.蚀刻后,玻璃表面粗糙度基本不变
4.直径,厚度的减薄量与理论计算值一致

510*515mm玻璃基板
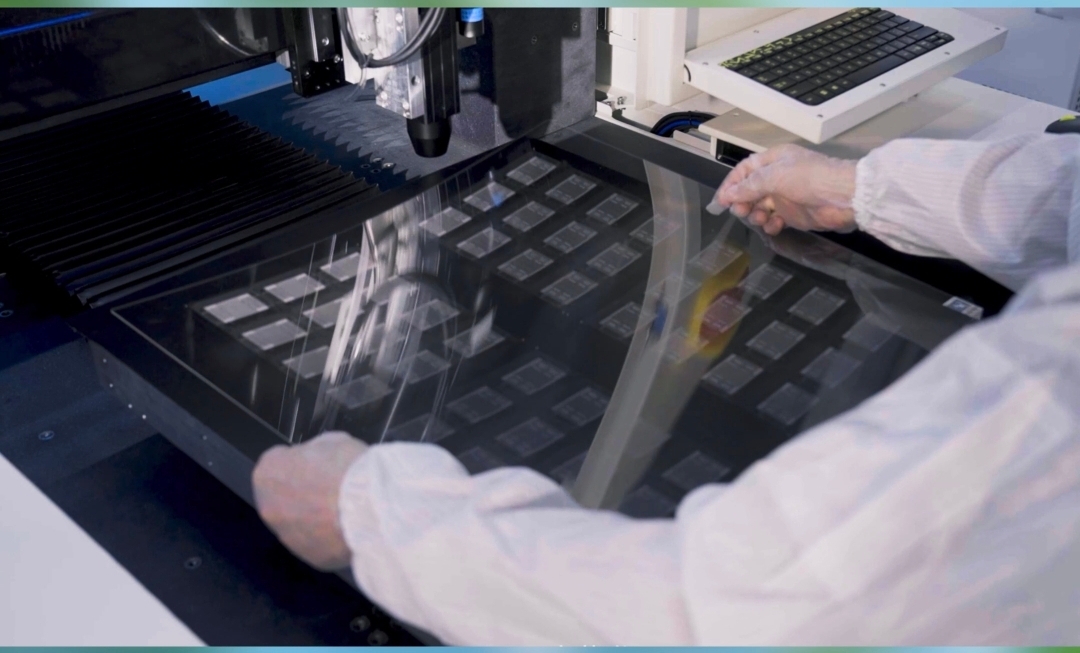
510*515mm玻璃基板
显微镜下:孔径50um

玻璃基板凭借优异电学性能、良好热稳定性与低翘曲特性,面向芯粒、2.5D/3D集成及晶圆级封装发展趋势,有望成为新一代先进封装基板。玻璃通孔(TGV-Through Glass Via)技术是玻璃基板高密度电气连接的核心路径,可赋能芯片2.5D/3D封装,匹配AI+Chiplet需求,为高密度垂直互连与三维堆叠提供可行性,拓宽高端封装应用前景。
作为玻璃激光钻孔设备供应商,圭华智能深耕TGV玻璃通孔技术,引领玻璃基板封装产业不断升级。
①:引用于玻璃通孔(TGV)技术的前景及机遇《股市动态分析:研究部》
②:玻璃基板在芯片封装中的应用和性能要求_张兴治
(TGV:Through Glass Via,玻璃通孔技术)